
SiC单晶片固结磨料化学机械抛光垫研制 - 道客巴巴
2019年6月30日 全日制硕士学位论文Researchofchemicalmechanicalfixed-abrasivepolishingpadofSiCsinglecrystal申请人姓名:刘志响指导教师:苏建修教授学位 ...2019年12月10日 我们综述了单晶SiC基片化学机械抛光加工的研究现状,根据加工原理进行归类并分析了各种类别的优缺点及运用局限,指出了其在化学机械抛光领域的发展前景。单晶SiC基片的化学机械抛光技术研究进展
了解更多
SiC单晶片C面固结磨料化学机械抛光的研究 - 百度学术
本文研究了三种不同种类的磨料对SiC单晶片去除率的影响.最终选用金刚石磨料作为SiC单晶片的化学机械抛光磨料.结果表明:固结磨料CMP的材料去除率是游离磨料的3倍以上,固结 2022年7月30日 摘要: 由于单晶碳化硅 (SiC) 的传统化学机械抛光 (chemical mechanical polishing, CMP)技术加工效率低, 故提高 SiC 表面质量和材料去除率成为研究热点. 总结了 单晶 SiC 的化学机械抛光及辅助技术的研究进展
了解更多
单晶SiC的化学机械抛光及其增效技术研究进展 - 哈尔滨工业 ...
2019年10月24日 摘要: 为了解决传统SiC化学机械抛光(CMP)加工效率低的问题,针对单晶SiC表面抛光质量和材料去除率指标,综述了应用传统碱性抛光液、混合磨粒抛光液及含 【摘 要】为了解决传统SiC化学机械抛光(CMP)加工效率低的问题,针对单晶SiC表面抛光质量和材料去除率指标,综述了应用传统碱性抛光液、混合磨粒抛光液及含强氧化剂抛光液对 单晶SiC的化学机械抛光及其增效技术研究进展_百度文库
了解更多
SiC单晶片固结磨料化学机械抛光垫研制-硕士-中文学位【掌 ...
2022年8月17日 当前用于GaN基LED的衬底材料比较多,但是能用于商品化的衬底材料,目前只有蓝宝石(Al2O3)和碳化硅(SiC)衬底。 由于SiC单晶衬底化学稳定性好、导电 2020年3月22日 摘要: 单晶SiC因其优异的物理化学性质而成为重要的外延衬底材料,广泛应用于卫星通信、集成电路和消费电子等领域.衬底外延生长需要单晶SiC具有较低的加工 单晶SiC基片的化学机械抛光技术研究进展 - wanfangdata.cn
了解更多
单晶SiC的化学机械抛光及其增效技术研究进展-期刊-钛学术 ...
为了解决传统SiC化学机械抛光 (CMP)加工效率低的问题,针对单晶SiC表面抛光质量和材料去除率指标,综述了应用传统碱性抛光液、混合磨粒抛光液及含强氧化剂抛光液对单晶SiC 出现检索词的位置SiC单晶片固结磨料化学机械抛光液设计 - 百度学术
了解更多
郑州千磨谈:半导体|碳化硅晶片的化学机械抛光技术实践sic ...
2024年3月22日 在半导体领域中,经过化学机械抛光后SiC单晶片获得超光滑、无缺陷及无损伤表面是高质量外延层生长的决定因素。01、传统化学机械抛光介绍 SiC的传统化学机械抛光按照磨料存在状态可分为游离磨料抛光和固结磨料抛光。2020年5月6日 化学机械抛光(CMP)是目前实现单晶SiC基片超精密加工的一种常用且有效方法。我们综述了单晶SiC基片化学机械抛光加工的研究现状,根据加工原理进行归类并分析了各种类别的优缺点及运用局限,指出了其在化学机械抛光领域的发展前景。单晶SiC基片的化学机械抛光技术研究进展sic磨料金刚石铁 ...
了解更多
单晶SiC基片的化学机械抛光技术研究进展
2019年12月10日 化学机械抛光(CMP)是目前实现单晶SiC基片超精密加工的一种常用且有效方法。我们综述了单晶SiC基片化学机械抛光加工的研究现状,根据加工原理进行归类并分析了各种类别的优缺点及运用局限,指出了其在化学机械抛光领域的发展前景。2021年10月27日 1.本发明涉及超精密加工技术领域,尤其涉及一种具有自退让性的固结磨粒化学机械抛光垫及其制备方法和应用。背景技术: 2.单晶sic是继ge和si等第一代半导体材料、gaas、inp等第二代半导体材料发展起来的第三代半导体材料,在半导体照明、新一代移动通信、智能电网、高速轨道交通、新能源汽车 ...一种具有自退让性的固结磨粒化学机械抛光垫及其制备方法 ...
了解更多
行业知识小课堂!半导体|碳化硅晶片的化学机械抛光技术
2024年3月22日 在半导体领域中,经过化学机械抛光后SiC单晶片 获得超光滑、无缺陷及无损伤表面是高质量外延层生长的决定因素。 ... FA-CMP工艺是把磨料固结在抛光垫中,研磨液不再添加磨料,而是只含有基本化学成分的水溶液或去离子水。来自外部的压力 ...2023年12月12日 单位代码10467分类号TH161SiC单晶基片固结磨粒摩擦化学机械抛光界面温度产生机理研究:超精密加工理论与技术申请学位类别 ...SiC单晶基片固结磨粒摩擦化学机械抛光界面温度产生机理研究 ...
了解更多
超声辅助单晶SiC晶片的研磨与化学机械抛光研究 - 道客巴巴
2020年2月8日 SiC单晶片化学机械研磨试验研究 星级: 5 页 SiC 单晶片化学机械研磨试验研究 - 表面技术 星级: 5 页 SiC单晶片研磨材料去除率研究_袁启龙 星级: 7 页 SiC单晶片固结磨料化学机械抛光垫研制 星级: 81 页 硅单晶片研磨液的研究 星级: 3 页最终选用金刚石磨料作为 S i C单 晶片 的化学机械抛光磨 料。 结 果表 明 : 固结磨料 C M P的材料去除率是游离磨料 的 3倍 以上 , 固结磨料抛光垫, 可大 幅度提高材料去除效率 。 关键词 : 固结磨料 ; S i C晶体 ; 化学机 械抛光 ; 材 料去除SiC单晶片C面固结磨料化学机械抛光的研究_百度文库
了解更多
SiC单晶片固结磨料化学机械抛光液设计 - 百度学术
出现检索词的位置“单晶SiC的化学机械抛光及其增效技术研究进展”出自《哈尔滨工业大学学报》期刊2018年第7期文献,主题关键词涉及有碳化硅(SiC)、化学机械抛光(CMP)、电化学机械抛光(ECMP)、催化辅助、固结磨粒抛光等。钛学术提供该文献下载服务。单晶SiC的化学机械抛光及其增效技术研究进展-期刊-钛学术 ...
了解更多
固结磨料抛光垫的制备与抛光应用研究 - 杭州九朋新材料有限 ...
2019年11月18日 固结磨料化学机械抛光技术也正是在这种情况下提出的,将输入变量集中在抛光垫身上,对抛光液和工件特征依赖性很小,是一种由非确定性精密加工转化成半确定性精密加工的绿色加工技术。1.3 固结磨料化学机械抛光技术 1.3.1 FA-CMP 的技术特点及优势本文以2英寸6H-SiC单晶片为对象,研究固结磨料摩擦化学机械研磨法对碳化硅单晶片材料去除率、表面粗糙度的影响,并探究其摩擦化学反应过程和材料去除 机理。主要研究内容如下:(1)游离磨料摩擦化学机械研磨SiC基片研磨膏研究采用单因素试验法研究研磨 ...SiC单晶基片固结磨粒摩擦化学机械研磨研究 - 百度学术
了解更多
SiC单晶片固结磨料化学机械抛光垫研制--SiC单晶片论文下载
2018年10月5日 SiC单晶片固结磨料化学机械抛光垫研制是一篇硕士论文,爱博士论文提供最新人造超硬度材料的生产硕士论文下载,包括工业技术论文,化学工业论文,电热工业、高温制品工业论文,人造超硬度材料的生产论文,几百个学科,四百多万篇优秀论文,欢迎下载!2024年3月22日 在半导体领域中,经过化学机械抛光后SiC单晶片获得超光滑、无缺陷及无损伤表面是高质量外延层生长的决定因素。01、传统化学机械抛光介绍 SiC的传统化学机械抛光按照磨料存在状态可分为游离磨料抛光和固结磨料抛光。郑州千磨谈:半导体|碳化硅晶片的化学机械抛光技术实践
了解更多
SiC单晶片C面固结磨料化学机械抛光的研究-张竹青罗玉梅 ...
2024年4月24日 本文研究了三种不同种类的磨料对SiC单晶片去除率的影响。最终选用金刚石磨料作为SiC单晶片的化学机械抛光磨料。结果表明:固结磨料CMP的材料去除率是游离磨料的3倍以上,固结磨料抛光垫,可大幅度提高材料去除效率。SiC单晶片C面固结磨料化学机械抛光的研究-( Z h e n g z h o u u n i v e r s i t y o f i n d u s t r i a l t e c h n o l o g y , Z h e 首页 文档 视频 音频 文集 文档 公司财报 行业研究 ...SiC单晶片C面固结磨料化学机械抛光的研究_百度文库
了解更多
固结磨料摩擦化学机械抛光单晶SiC基片微区富氧机制_祁 ...
2022年9月25日 单位代码10467分类号TH161申请号10190141密级硕硕士学位论文晶固结磨料摩擦化学机械抛光单晶SiC基片微区富氧机制学科专业:机械工程研究方向:超精密加工理论与技术申请学位类别:工学硕士作者姓名:祁婉婷导师姓名:苏建修教授二〇二二年重点研究应用热-化学-机械能量耦合固结磨料研磨盘研磨及热-化学-机械能量耦合固结磨料抛光垫抛光SiC单晶基片过程中在热作用下的微观力学行为、物理化学效应、机械摩擦作用及能量耦合机理,分析其材料去除、平整度和表面形成机理以及表面损伤的产生机理耦合能量超精密加工SiC单晶基片的机理与工艺研究-国家 ...
了解更多
提拉法制备铜单晶基片的化学机械抛光研究 - 豆丁网
2014年4月12日 采用化学机械抛光(CMP)方法对 Cu单晶基片进行抛光,借助光学显微镜、表面轮廓仪和扫描探针显微镜分析了基片表面形貌、表面粗糙度与表面 均匀性,并探讨了抛光压力、表面活性剂和抛光垫对基片表面抛光的影响,结果表明:采用CMP加工后的铜单晶基2019年5月25日 第50卷 第7期 哈 尔 滨 工 业 大 学 学 报 Vol50 No7 20 18年7月 JOURNAL OF HARBIN INSTITUTE OF TECHNOLOGY Jul. 2018 DOI:10.11918/ j.issn.0367⁃6234.201803130 单晶SiC的化学机械抛光及其增效技术研究进展 翟文杰,高 博 (哈尔滨工业大学 机电工程学院,哈尔滨 150001) 摘 要:为了解决传统SiC化学机 单晶SiC的化学机械抛光及其增效技术研究进展.pdf - 原创力文档
了解更多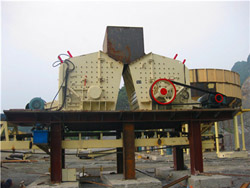
干式摩擦化学机械抛光:更绿色环保的SiC抛光工艺?_粉体 ...
2 天之前 相比之下,干式摩擦化学机械抛光是一种基于摩擦化学磨损的新技术,通过摩擦产生的热量、硬质抛光盘的机械作用和金属催化,去除材料表面并实现高效抛光。摩擦化学机械抛光装置 例如,单晶SiC基片的干式摩擦化学机械抛光原理如下图所示。在相同工艺参数下使用现有的化学机械抛光实验装置,研究了以下几个方面的参数对影响SiC晶片抛光加工效果的影响,改变芬顿体系抛光液中的催化剂Fe的形态和价位;.改变抛光液中的磨粒种类以及粒径大小,改变磨料在抛光液中的质量百分比,改变抛光液中的pH值基于芬顿反应的单晶SiC化学机械抛光液研究 - 百度学术
了解更多
单晶SiC的化学机械抛光及其增效技术研究进展_百度文库
1.单晶SiC化学机械抛光液化学反应参数研究 [J], 阎秋生;徐少平;路家斌;宋涛 2.SiC单晶片C面固结磨料化学机械抛光的研究 [J], 张竹青;罗玉梅 3.单晶SiC基片的化学机械抛光技术研究进展 [J], 邓家云; 潘继生; 张棋翔; 郭晓辉; 阎秋生针对单晶SiC化学机械抛光使用的抛光液,研究了产生芬顿反应Fe、FeO、Fe 2 O 3 、Fe 3 O 4 等4种铁系固相催化剂的效果。结果发现当Fe 3 O 4 作为催化剂时,SiC 表面能够产生明显的化学反应,生成较软易去除的SiO 2 氧化层,化学机械抛光时 ...单晶SiC化学机械抛光液的固相催化剂研究
了解更多
CMP Slurry均一性的一体化解决方案(短篇)-上海奥法美嘉 ...
2023年2月23日 CMP 流程概述 在 CMP 抛光液中,一般使用水基抛光液作为加工介质,以去离子水作为溶剂,加入磨料(如 SiO2、ZrO2 纳米粒子等)、分散剂、pH 调节剂以及氧化剂等组分,每个组分都具有相应的功能,对化学机械抛光过程起到不同的作用。 珠磨机 均质抛光液后经过过滤 通过 PSS 的 Nicomp 粒度分析仪 ...1.SiC单晶片C面固结磨料化学机械抛光的研究 [J], 张竹青;罗玉梅 2.基于蒙特卡罗方法的4H-SiC(0001)面聚并台阶形貌演化机理 [J], 李源;石爱红;陈国玉;顾秉栋 3.催化剂浓度对6H-SiC晶片Si面化学机械抛光性能的影响 [Jቤተ መጻሕፍቲ ባይዱ, 滕康;陈国美;倪自丰 ...SiC(0001)面和(000-1)面CMP抛光对比研究_百度文库
了解更多
超声辅助单晶SiC晶片的研磨与化学机械抛光研究 - 百度学术
对于磨料的二体磨损,采用刻划的方式对单晶SiC表面分别进行了不同刻划速率与刻划深度的仿真模拟;对于超声辅助下磨料的力学特性变化,探究了磨料在不同印压速率、冲击角度以及不同频率下对单晶SiC的力学作用。(2)分析了化学机械抛光机理与材料去除模型1.SiC单晶片C面固结磨料化学机械抛光的研究 [J], 张竹青;罗玉梅 2.单晶SiC的化学机械抛光及其增效技术研究进展 [J], 翟文杰;高博 3.单晶SiC基片的化学机械抛光技术研究进展 [J], 邓家云; 潘继生; 张棋翔; 郭晓辉; 阎秋生单晶SiC化学机械抛光液化学反应参数研究_百度文库
了解更多
单晶SiC基片干式摩擦化学机械抛光初探
2023年3月6日 采用最优工艺参数对表面粗糙度约为20 nm的单晶6H-SiC基片进行干式抛光加工,最终获得表面粗糙度 R a 为3.214 nm。DTCMP方法抛光SiC基片比水基抛光法热量损失少,所产生的界面温度更高,反应所需的活化能更低,可以实现SiC基片的
了解更多




